IC 布局在被代工厂或 IDM 接受制造之前,要经过广泛的设计规则检查以确保正确性。在芯片制造过程中会发生一种称为天线效应的现象,其中等离子体引起的损伤 (PID) 会降低 MOSFET 器件的可靠性。布局设计人员运行设计规则检查 (DRC) 以查找违反 PID 的区域,然后进行编辑以通过所有检查。
传统的天线设计规则将测量金属(或通孔)层与MOSFET栅极层的关系,如果面积比太大,则必须通过添加保护二极管来固定布局。

针对天线效应的传统 DRC 无法处理的一种 IC 布局方案是具有多个电源域的 AMS 设计,使用多个隔离的 P 型阱,如下所示。以下四种场景需要一种称为基于路径的验证的新方法。




这四种布局方案只能通过 EDA 工具来检测,该工具在金属和 MOSFET 栅极层的面积计算过程中了解器件、连接性和电气路径。这就是 口径 PERC 西门子 EDA 工具应运而生,因为它可以执行复杂的基于路径的检查来识别 PID 区域、查找静电放电 (ESD) 问题并找到设计团队正在寻找的其他路径。以下是使用 Calibre PERC 的 PID 流程:

在 IC 布局上使用此流程并在 Calibre RVE 结果查看器中查看结果表明发现了 PID 违规,因为在金属 1 级别建立了风险连接,但直到金属 2 级别才发生保护连接。

下一个 PID 违规是根据金属层和 N 埋层 (nbl) 的不平衡面积比确定的。以紫色 (rve) 突出显示的区域是受害设备。

为了获得完整的 PID 覆盖,您的设计团队必须同时使用传统的基于 DRC 的天线检查和基于路径的检查。作为预防步骤,在设计阶段早期运行 DRC 类型检查。随着布局中更多金属连接的完成,然后形成跨隔离 P 型阱的路径,是时候添加基于路径的验证,以提供完整的覆盖范围。
在此早期 IC 布局中,需要运行传统的基于 DRC 的天线检查,以确认布局通过 PID 验证。
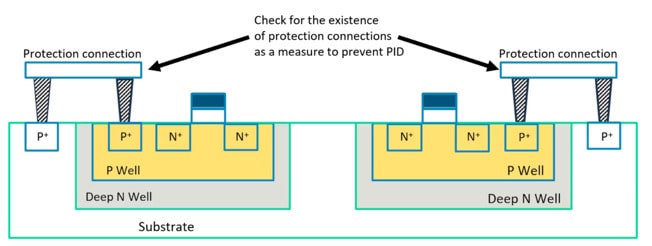
随着越来越多的金属路径添加到 IC 布局中,就需要使用基于路径的工具了,因为它可以正确理解风险连接和保护连接。
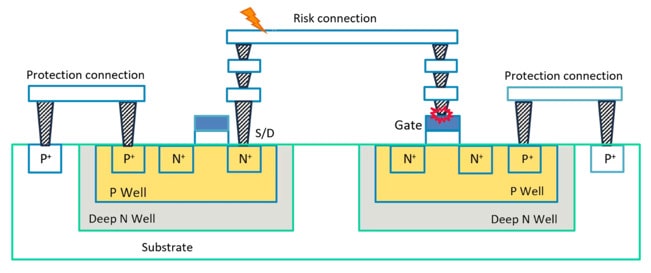
总结
IC 布局必须满足严格的设计规则,以通过所使用的代工厂或晶圆厂工艺设定的可靠性和良率要求。传统的基于 DRC 的天线设计规则仍可用于早期布局,但随着添加更多金属层以完成互连,则需要使用 Calibre PERC 进行基于路径的检查。
随着跨隔离 P 阱的路径建立,Calibre PERC 基于路径的流程可用于检查 IP、块/模块甚至全芯片级别的 IC 布局以进行签核。因此,建议同时使用这两种流程来满足可靠性和良率目标。
阅读 技术论文 在西门子在线。
相关博客
通过以下方式分享此帖子:
- :具有
- :是
- :在哪里
- ][p
- a
- 关于
- 公认
- 横过
- 加
- 添加
- 添加
- 所有类型
- an
- 和
- 天线
- 的途径
- 保健
- 国家 / 地区
- 地区
- AS
- At
- BE
- 因为
- 成为
- before
- 作为
- 如下。
- 之间
- 都
- 但是
- by
- 计算
- 被称为
- CAN
- 不能
- 查
- 检查
- 支票
- 芯片
- 购买的订单均
- 完成
- 完成
- 复杂
- 确认
- 地都
- 连接
- 连接方式
- 正确性
- 覆盖
- 损伤
- 设计
- 设计师
- 设计
- 检测
- 设备
- 设备
- 二极管
- 域名
- 刚果(金)
- ,我们将参加
- 早
- 早期
- 效果
- 影响
- 确保
- 成熟
- 甚至
- 广泛
- 最后
- 找到最适合您的地方
- 固定
- 流
- 流动
- 以下
- 针对
- 申请
- 发现
- 铸造厂
- 四
- 止
- 门
- 得到
- Go
- 理想中
- 团队
- 处理
- 发生
- 发生
- 有
- 突出
- HTTPS
- 确定
- 鉴定
- if
- in
- 互连
- IP
- 孤立
- 问题
- 问题
- IT
- JPG
- 知道
- 大
- 层
- 层
- 布局
- Level
- 各级
- 寻找
- 降低
- 制成
- 使
- 制造业
- 最大宽度
- 衡量
- 满足
- 某些金属
- 分钟
- 更多
- 多
- 必须
- 必要
- 全新
- 下页
- of
- on
- 在线
- 仅由
- or
- 其他名称
- 通过
- 通行证
- 路径
- 演出
- 柏拉图
- 柏拉图数据智能
- 柏拉图数据
- 加
- 帖子
- 功率
- 防止
- 过程
- 正确
- 保护
- 优
- 比
- 比
- 建议
- 可靠性
- 必须
- 岗位要求
- 成果
- 严格
- 风险
- 第
- 定位、竞价/采购和分析/优化数字媒体采购,但算法只不过是解决问题的操作和规则。
- 运行
- 脚本
- 情景
- 集
- 显示
- 如图
- Siemens
- So
- 东西
- 实习
- 步
- 仍
- 团队
- 这
- 区域
- 然后
- Free Introduction
- 通过
- 次
- 至
- 一起
- 也有
- 工具
- 传统
- 二
- 理解
- 直到
- 使用
- 用过的
- 运用
- 验证
- 企业验证
- 通过
- 受害者
- 观众
- 违反
- 违反
- 是
- 井
- 井
- 将
- 产量
- 您一站式解决方案
- 和风网