Раньше атомно-слоевое осаждение (ALD) считалось слишком медленным, чтобы его можно было использовать на практике в производстве полупроводников, но оно стало важнейшим инструментом для изготовления как транзисторов, так и межсоединений на самых передовых узлах.
ALD можно несколько ускорить, но реальный сдвиг заключается в растущей ценности точного контроля состава и толщины на самых продвинутых узлах, что оправдывает дополнительное время, затрачиваемое на осаждение.
АЛД является близким родственником химическое осаждение из паровой фазы, первоначально представленный в больших объемах в полупроводниковой промышленности для диэлектриков затвора из оксида гафния (high-k). И CVD, и ALD по своей сути являются конформными процессами. Осаждение происходит на всех поверхностях, подвергающихся воздействию газа-прекурсора. Однако при АЛД реакция носит самоограничивающийся характер.
Процесс работает следующим образом: сначала газ-прекурсор (А) вводится в технологическую камеру, где он адсорбируется на всех доступных участках подложки. После того, как все участки поверхности заняты, дальнейшей адсорбции не происходит. Инертный продувочный газ, обычно азот или аргон, вымывает оставшийся газ-прекурсор, затем вводится второй предшественник (В). Прекурсор B реагирует с хемосорбированным предшественником A с образованием желаемой пленки. Как только все адсорбированные молекулы будут израсходованы, реакция прекращается. После второго этапа очистки цикл повторяется.
Возможности ALD расширяются по мере сокращения функций
Поэтапный характер АЛД является одновременно его силой и слабостью. Нанесение одного монослоя за раз дает производителям чрезвычайно точный контроль толщины. Использование различных газов-прекурсоров в разных соотношениях позволяет настроить состав пленки. К сожалению, повторяющиеся циклы прекурсора/продувочного газа занимают много времени. В интервью исследователь CEA-Leti Реми Гассиллу подсчитал, что в процессе производства одной пластины две минуты на пластину — это максимально экономически эффективное время процесса. Но двух минут достаточно, чтобы нанести пленку толщиной около 2 нм.
Некоторые корректировки процесса могут улучшить производительность. Диоксид кремния ALD часто использует большие печи для одновременной обработки множества пластин. Плазменная активация может ионизировать реагенты и ускорить образование пленок. Тем не менее, по оценкам Гасиллуда, максимальная практическая толщина пленок ALD составляет 10 нм.
Однако по мере сжатия транзисторов количество слоев в этом диапазоне толщины увеличивается. Транзисторные структуры также становятся все более сложными и требуют нанесения на вертикальные поверхности, в глубокие траншеи и другие места, недоступные для методов PVD на прямой видимости. Запасные ворота для затвор все вокруг транзисторы, например, нуждаются в процессе, который может заполнить полости нанометрового размера.
Как отмечалось выше, HfO2 было первым успешным применением ALD в производстве полупроводников. Его предшественники, HfCl4 и вода представляют собой химически простые небольшие молекулы, побочные продукты которых летучи и легко удаляются. Однако такие простые химические процессы являются исключением. В ALD диоксида кремния обычно используются предшественники аминосиланов.[1] Нитриды металлов часто содержат сложные металлоорганические газы-прекурсоры. Гасиллу отметил, что лиганды могут быть добавлены к молекуле-предшественнику, чтобы изменить давление ее пара или реакционную способность или облегчить адгезию к подложке. В процессах селективного осаждения, обсуждаемых ниже, лиганды могут улучшить селективность между растущими и нерастущими поверхностями. Эти более крупные молекулы может быть трудно проникнуть в более мелкие детали, а побочные продукты может быть трудно удалить. Сложные побочные продукты также могут стать источником загрязнения.
Одним из преимуществ ALD является очень низкая температура процесса, обычно от 200°C до 300°C. Он термически совместим как с транзисторами, так и с межсоединениями в КМОП, а также с осаждением на пластик и другие новые подложки. Несмотря на это, Адитья Кумар и его коллеги из GlobalFoundries показали, что точный контроль температуры важен.[2] Конденсация TDMAT (тетракис-диметиламинотитана) в процессе осаждения TiN была существенным источником дефектов частиц. Для поддержания желаемой температуры процесса важна температура как прекурсора, так и продувочного газа. Подача холодного продувочного газа в теплую технологическую камеру может вызвать быструю конденсацию.
Поскольку ALD стал широко распространенным процессом, промышленность нашла для него применение не только в материалах основных устройств, но и в различных жертвенных и разделительных слоях. Например, в схемах с двойным и четверным паттерном часто используется ALD для «удвоения высоты звука». Нанеся разделительный материал на обе стороны узорчатой «оправки», а затем удалив оправку, можно сократить исходный шаг вдвое без необходимости выполнения дополнительного, более дорогостоящего этапа литографии.[3]
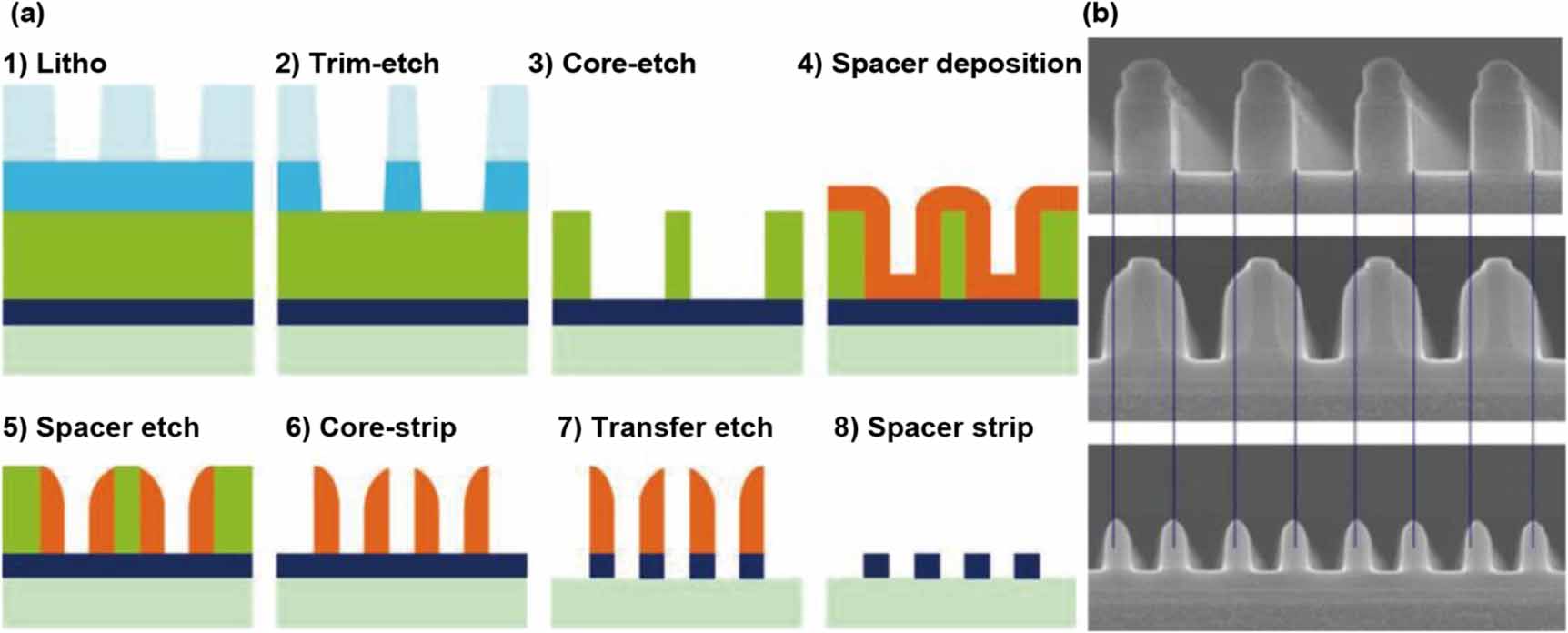
Рис. 1: Самовыравнивающийся двойной рисунок с проставками ALD. Источник: Creative Commons.
Нанесение легированного оксида на вертикальные кремниевые ребра устройства finFET является менее направленной и менее разрушительной альтернативой ионной имплантации.4]
Выборочное осаждение обеспечивает боковой контроль
Последние два примера зависят от характеристик поверхности, способствующих осаждению. Прекурсор может легче прилипать к твердой маске, чем к основному материалу. Вертикальная грань кремниевого ребра может иметь больше (или меньше) мест адсорбции, чем горизонтальная грань. Для селективного осаждения на более сложные структуры может потребоваться предварительно нанесенный шаблон роста, функционализирующий области субстрата, чтобы стимулировать или препятствовать росту. Селективное осаждение особенно важно в межкомпонентных соединениях. В целом, однако, всесторонний обзор, проведенный Ронг Ченом и его коллегами из Университета науки и технологий Хуачжун, объяснил, что методы избирательного осаждения требуют пополнения материала шаблона по мере роста пленки, но при этом необходим механизм для выборочного удаления нежелательного материала.[5]
Например, вольфрам преимущественно осаждается на кремнии, а не на SiO.2, но селективность снижается уже после нескольких циклов. Исследователи из Университета штата Северная Каролина успешно повторно пассивировали оксид, включив водород в предшественник вольфрама.[6] Аналогично, группа из Аргоннской национальной лаборатории обнаружила, что SiO2 преимущественно осаждается на SiO2 по сравнению с другими оксидами всего за 10–15 циклов. Так называемый цикл «ABC» — добавление ацетилацетона («Прекурсор C») в качестве ингибитора каждые 5–10 циклов — восстановил селективность.
В качестве альтернативы или в дополнение к этому для удаления нежелательного материала можно использовать атомно-слоевое травление (ALE). ALE работает так же поэтапно, как и ALD. Первая половина цикла вступает в реакцию с существующей поверхностью, ослабляя связь с основным материалом. Затем второй этап — обычно ионная бомбардировка — удаляет ослабленный слой. Например, при травлении кремния ALE газообразный хлор реагирует с поверхностью с образованием различных SiCl.x соединения. Процесс хлорирования ослабляет межкремниевые связи между поверхностью и объемом, и хлорированный слой легко распыляется. Послойный характер ALE зависит от преимущественного удаления поверхностного материала по сравнению с объемным (SiClx против Си в данном случае). «Окно ALE» — это сочетание энергии и температуры, при котором поверхностный слой полностью удаляется без повреждения нижележащего материала.
Как ни странно, Керен Канарик и коллеги из Lam Research обнаружили, что более высокие энергии ионов фактически расширяют окно ALE для травления кремния. Высокие энергии ионов с коротким временем воздействия задерживают начало распыления кремния по сравнению с обычным RIE.[8]
Сложение и вычитание по одному атомному слою за раз.
В течение долгого времени полупроводниковая промышленность искала альтернативы схемам обработки, в которых материал наносится, формируется его структура, а затем вытравливается большая его часть. Не проще ли было бы разместить только тот материал, который нам в конечном итоге понадобится? Между тем, атомно-слоевое осаждение заполняет пространство под нанолистами и внутренние полости. Инструменты для массового осаждения и травления все еще с нами и будут в обозримом будущем. Однако во все большем количестве случаев эти инструменты обеспечивают основу, а процессы ALD и ALE дополняют детали.
Рекомендации
- Венлинг Ли и др., «Влияние структуры предшественников аминосилана и силанола на процесс осаждения атомных слоев», Applied Surface Science, Vol 621, 2023,156869, 10.1016, https://doi.org/2023.156869/j.apsusc.XNUMX.
- Кумар и др., «Уменьшение поверхностных дефектов ALD TiN для 12-нм и других технологий», 2020-я ежегодная конференция SEMI Advanced Semiconductor Manufacturing Conference (ASMC), 31 г., Саратога-Спрингс, Нью-Йорк, США, 2020 г., стр. 1–4, doi: 10.1109/ ASMC49169.2020.9185271.
- Шохей Ямаути и др., «Расширяемость множественных паттернов самовыравнивающегося типа для дальнейшего масштабирования», Proc. SPIE 8682, Достижения в области резистивных материалов и технологий обработки XXX, 86821D (29 марта 2013 г.); https://doi.org/10.1117/12.2011953
- Калкофен и др., «Атомно-слоевое осаждение пленок оксида фосфора в качестве твердых источников легирования полупроводниковых структур», 2018-я Международная конференция IEEE по нанотехнологиям (IEEE-NANO, 18 г.), Корк, Ирландия, 2018 г., стр. 1–4, doi. : 10.1109/NANO.2018.8626235.
- Ронг Чен и др., «Осаждение на атомном уровне для расширения закона Мура и его пределы», 2020 Int. Дж. Экстрем. Производитель 2 022002 ДОИ 10.1088/2631-7990/ab83e0
- Б. Каланян и др., «Использование водорода для расширения окна селективности подложки во время осаждения атомного слоя вольфрама», Chem. 2016. Матер. 28 117–26 https://doi.org/10.1021/acs.chemmater.5b03319
- Янгуас-Гил А., Либера Дж.А. и Элам Дж.В., «Модуляция роста за цикл при осаждении атомных слоев с использованием обратимой функционализации поверхности», Chem. 2013 г. Матер. 25 4849–60 https://doi.org/10.1021/cm4029098
- Керен Дж. Канарик и др., «Универсальное соотношение масштабирования для травления атомных слоев», J. Vac. наук. Технол. А 39, 010401 (2021 г.); дои: 10.1116/6.0000762
- SEO-контент и PR-распределение. Получите усиление сегодня.
- PlatoData.Network Вертикальный генеративный ИИ. Расширьте возможности себя. Доступ здесь.
- ПлатонАйСтрим. Интеллект Web3. Расширение знаний. Доступ здесь.
- ПлатонЭСГ. Углерод, чистые технологии, Энергия, Окружающая среда, Солнечная, Управление отходами. Доступ здесь.
- ПлатонЗдоровье. Биотехнологии и клинические исследования. Доступ здесь.
- Источник: https://semiengineering.com/enabling-advanced-devices-with-atomic-layer-processes/
- :имеет
- :является
- :нет
- :куда
- $UP
- 1
- 10
- 15%
- 18
- 2%
- 2013
- 2016
- 2018
- 2020
- 2021
- 2023
- 25
- 28
- 29
- 31
- 39
- 5
- 7
- 8
- a
- О нас
- выше
- ускорять
- доступной
- Активация
- на самом деле
- добавленный
- добавить
- дополнение
- дополнительный
- придерживаться
- корректировки
- продвинутый
- авансы
- Преимущества
- После
- AL
- Все
- причислены
- альтернатива
- альтернативы
- an
- и
- годовой
- любой
- Применение
- Приложения
- МЫ
- Национальная лаборатория Аргон
- AS
- At
- доступен
- прочь
- b
- BE
- становиться
- становление
- было
- ниже
- между
- Beyond
- связь
- Облигации
- изоферменты печени
- Приносит
- одной посылкой
- но
- by
- CAN
- Каролина
- случаев
- случаев
- Вызывать
- полости
- камера
- изменение
- характеристика
- чен
- Закрыть
- холодный
- коллеги
- сочетание
- совместим
- полностью
- комплекс
- сложный
- композиция
- комплексный
- Конференция
- считается
- потребленный
- контроль
- обычный
- Основные
- рентабельным
- дорогостоящий
- творческий
- критической
- Порез
- цикл
- циклы
- повреждения
- глубоко
- дефект
- Задерживается
- зависеть
- зависит
- пополнять счет
- депонированный
- депонирование
- депозиты
- желанный
- подробнее
- устройство
- Устройства
- различный
- трудный
- отговаривать
- обсуждается
- двойной
- в течение
- Е & Т
- легко
- или
- появившийся
- позволяет
- поощрять
- энергетика
- достаточно
- особенно
- к XNUMX году
- Оценки
- Даже
- Каждая
- пример
- Примеры
- исключение
- существующий
- Расширьте
- расширенный
- объяснены
- подвергаться
- Экспозиция
- продлить
- дополнительно
- чрезвычайно
- Face
- содействовал
- Особенности
- несколько
- меньше
- Фига
- заполнять
- заполнение
- фильм
- пленки
- плавник
- FINS
- Во-первых,
- Что касается
- предвидимый
- форма
- образование
- найденный
- КАДР
- далее
- будущее
- ГАЗ
- ворота
- ворота
- Общие
- дает
- группы
- Растет
- Рост
- Половина
- Жесткий
- Есть
- High
- высший
- горизонтальный
- HTTPS
- Гидрирование
- IEEE
- важную
- улучшать
- in
- включения
- повышение
- промышленность
- свойственный
- по существу
- первоначально
- внутри
- пример
- Мультиязычность
- Интервью
- в
- выпустили
- введение
- Ирландия
- IT
- ЕГО
- JPEG
- Кумар
- лаборатория
- большой
- больше
- Фамилия
- закон
- слой
- слоев
- Меньше
- уровень
- li
- такое как
- Длинное
- много времени
- искать
- серия
- Низкий
- Mainstream
- поддерживать
- ДЕЛАЕТ
- способ
- Производители
- производство
- многих
- Март
- маска
- материала
- материалы
- Вопрос
- макс-ширина
- максимальный
- Май..
- Между тем
- механизм
- металл
- методы
- может быть
- минут
- молекула
- БОЛЕЕ
- самых
- с разными
- нанотехнологии
- национальный
- природа
- Необходимость
- нуждающихся
- нет
- узлы
- север
- Северная Каролина
- отметил,
- роман
- номер
- NY
- of
- предлагают
- .
- on
- консолидировать
- ONE
- только
- на
- работает
- Возможности
- or
- оригинал
- Другое
- внешний
- частица
- шаблон
- для
- Pitch
- Мест
- плазма
- пластик
- Платон
- Платон Интеллектуальные данные
- ПлатонДанные
- практическое
- необходимость
- предшественник
- преимущественный
- давление
- PROC
- процесс
- Процессы
- обработка
- производит
- обеспечивать
- ассортимент
- быстро
- коэффициенты
- реакция
- Реагирует
- легко
- реальные
- снижение
- районы
- отношения
- относительный
- осталось
- удаление
- удаление
- удален
- удаляет
- удаление
- повторный
- замена
- пополнять
- требовать
- исследователь
- исследователи
- сопротивляться
- восстановлено
- обратимый
- обзоре
- повышение
- то же
- масштабирование
- схемы
- SCI
- Наука
- Наука и технологии
- Во-вторых
- селективный
- Полуприцепы
- полупроводник
- сдвиг
- Короткое
- показал
- сторона
- значительный
- кремний
- Аналогичным образом
- просто
- простой
- одинарной
- Сайтов
- медленной
- небольшой
- меньше
- So
- твердый
- в некотором роде
- Источник
- Источники
- пространства
- потраченный
- Область
- Шаг
- По-прежнему
- Останавливает
- прочность
- Структура
- структур
- подложка
- вычитая
- успешный
- Успешно
- такие
- Поверхность
- взять
- технологии
- Технологии
- шаблон
- чем
- который
- Ассоциация
- тогда
- Эти
- этой
- те
- хоть?
- пропускная способность
- время
- раз
- Титан
- в
- слишком
- инструментом
- инструменты
- мелодия
- два
- напишите
- типично
- В конечном счете
- под
- лежащий в основе
- К сожалению
- Университет
- нежелательный
- us
- США
- использование
- используемый
- использования
- через
- ценностное
- разнообразие
- различный
- вертикальный
- очень
- летучий
- объем
- vs
- W
- теплый
- законопроект
- Вода
- we
- слабость
- ЧТО Ж
- который
- в то время как
- чья
- будете
- окно
- без
- работает
- стоит
- зефирнет












